
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.
電子デバイスの小型化、多機能化、高消費電力化、信頼性の向上に伴い、マイクロ電子デバイスの高密度三次元集積技術が登場しました。しかし、高密度集積化の発展は、チップ内の熱集中によって引き起こされるジャンクション温度の上昇によって制約され、デバイスの性能と信頼性が大幅に損なわれます。
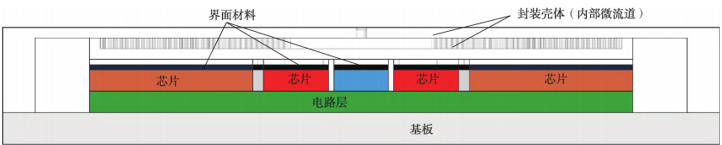
統合チップは、基板層、チップ回路層、チップ、パッケージ シェル コールド プレートで構成される多層構造を特徴としています。パッケージ シェルのコールド プレートには、均一なチップ温度分布を確保しながら、液体対流熱伝達を介して回路層チップから熱を放散するマイクロチャネルが組み込まれています。フレキシブル サーマル インターフェイス マテリアル (TIM) は、パッケージ シェルのコールド プレートと回路層の間のインターフェイスを橋渡しします。
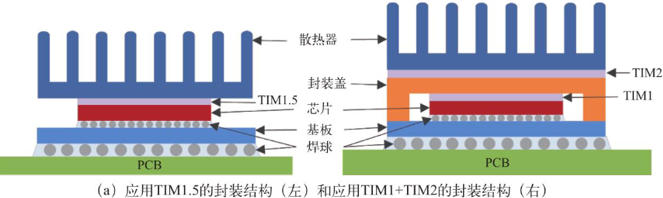
サーマル インターフェイス マテリアル (TIM) は、表面間の微細な隙間を埋めて熱性能を直接向上させる重要な放熱コンポーネントです。 TIM は通常、チップとパッケージの蓋 (TIM1)、チップとヒートシンク (TIM1.5)、およびパッケージの蓋とヒートシンク (TIM2) の間に適用されます。 TIM の高い熱伝導率と信頼性により、界面全体での迅速な熱伝達が保証されます。高計算能力チップに対する一般的な熱管理アプローチは、チップ内部からパッケージ ハウジングに熱を急速に伝導するために、依然として超低熱抵抗の TIM1 材料に依存しています。次に、熱は TIM2 材料を介して液冷プレートに伝達され、内部の冷却流体の急速な流れによって熱が外部環境に急速に放散されます。

March 05, 2026
March 04, 2026
July 22, 2025
July 16, 2025
この仕入先にメール
March 05, 2026
March 04, 2026
July 22, 2025
July 16, 2025

Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.

Fill in more information so that we can get in touch with you faster
Privacy statement: Your privacy is very important to Us. Our company promises not to disclose your personal information to any external company with out your explicit permission.